マイクロ構造体・MEMSデバイス作製支援
| 准教授 式田光宏 |
基盤技術
マイクロ構造体・MEMSデバイスを作製するための基盤技術:「ホトリソグラフィー」「薄膜形成」「エッチング加工」を支援します.ホトリソグラフィー工程では,両面露光装置を用いて基板表裏へのパターニングが可能です.薄膜工程では,逆スパッタリング,三元スパッタを用いて,基板上に多層金属薄膜を形成できます.また,生体適合性であるパリレンCフィルムを成膜することもできます.エッチング工程では,単結晶Siの結晶異方性エッチングを用いて,微細な構造体を作製できます.特に,上記結晶異方性エッチング技術に関しては,本グループ独自のデータベース及び秀でた技術力を保有しており,様々な微細構造体を作製できます.
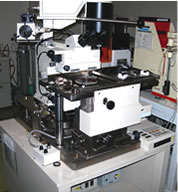
両面マスクアライナー
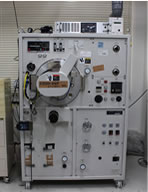
三元スパッタリング

結晶異方性エッチング
マイクロ構造体・MEMSデバイス作製技術
マイクロ構造体・MEMSデバイスの作製では,基板表面に上記ホトリソグラフィーで二次元の加工形状を入力し,それをエッチング加工にて基板深さ方向に展開し,微細な構造体を作製することになります.本グループでは,MEMSデバイス作製に対する多様なノウハウを有しており,上記単独の基盤技術のみならず,MEMSデバイス作製に対する一連の技術開発を支援することができます.具体例を以下に示します.

Si製マイクロニードルアレイ

Si製ミラーデバイス

カテーテル型MEMSセンサ
名古屋大学工学研究科附属マイクロナノメカトロニクス研究センター 式田光宏
Tel. 052-789-5031
E-mail : shikida![]() mech.nagoya-u.ac.jp
mech.nagoya-u.ac.jp
