プラズマプロセス・エッチング装置
ECR-SIMSエッチング装置
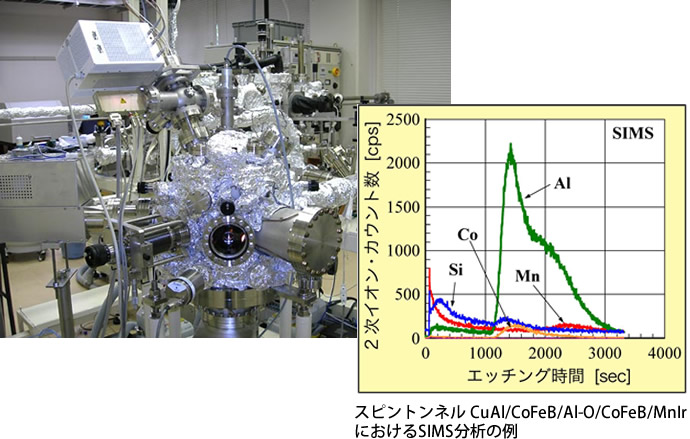
概要
電子サイクロトロン共鳴(ECR)プラズマ,ヘリコン波プラズマにより磁性薄膜のエッチングなどのプロセスを行います.二次イオン検出器(SIMS)によりエッチング中のモニタリングが可能で,エンドポイントディテクターとして利用できます.
仕様/性能
研究室による自作
到達真空度:1×10-7 Pa
サンプルステージ:X,Z移動機構,
サンプル傾斜,面内回転機構
[ECRプラズマ源]
入江工研 RGB-114L
マイクロ波(2.45 GHz)パワー:100 W
加速電圧:0-600 V
使用ガス:Ar, O2
最大加工寸法:30 mmφ
[二次イオン質量検出器]
PFEIFFER製 EDP400
分析質量:1-512 amu
ターボポンプによる差動排気機構
[ヘリコン波プラズマ源]
片桐エンジニアリング CHW-20
RF電力:1kW
使用ガス:Ar, O2
ビームサイズ:20 mmφ
ICPエッチング装置

概要
誘導結合方式高密度プラズマエッチング装置で化合物材料を高精度にドライエッチングし微細加工することができます.ロードロック室に試料を挿入すると全自動でエッチングを完了します.レシピ機能を活用することで再現性の良いエッチングが可能です.
仕様/性能
アルバック社製 CE-300I
化合物エッチング用
対応基板サイズ:最大6インチ
プロセスガス:Cl2
ICPエッチング装置
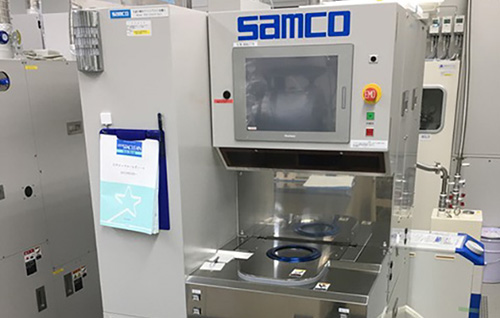
概要
誘導結合方式高密度プラズマエッチング装置で化合物材料を高精度にドライエッチングし微細加工することができます.ロードロック室に試料を挿入すると全自動でエッチングを完了します.レシピ機能を活用することで再現性の良いエッチングが可能です.
仕様/性能
サムコ社製 RIE-200iPN
対応基板サイズ:2インチ x 4枚
プロセスガス:Cl2, BCl3, O2
ICPエッチング装置一式
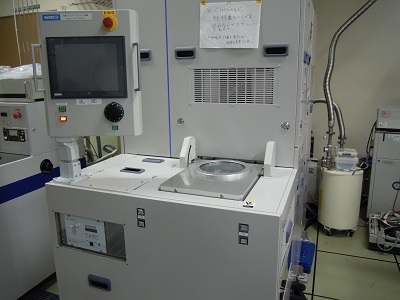
概要
本装置は放電形式に誘導結合方式を採用したMEMS,電子部品製作用途の高速シリコンディープエッチング装置です.高速ボッシュプロセスに対応するためプラズマ発生源と反応器構造を有し,高速シリコンディープエッチングが可能でき,ガスの高速切替を行うことにより、エッチングレートを維持したままスキャロップの低減が可能です.
仕様/性能
サムコ社製 RIE-800
ロードロック式装置
ボッシュプロセス対応
ウエハー貫通エッチングが可能
ウェーハサイズ:6 inch
加工速度:50 um/min
加工ガス:SF6,C4F8,O2,Ar
RIEエッチング装置
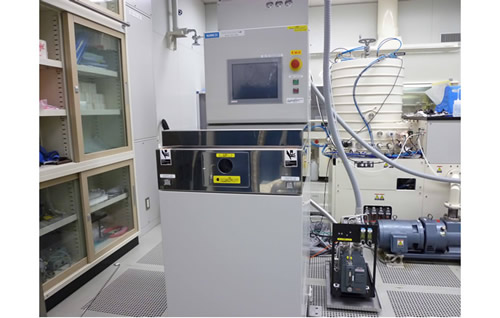
概要
並行平板型反応性イオンエッチング装置でシリコン,シリコン酸化膜等各種シリコン薄膜を高精度にドライエッチングすることができます.全自動運転でレシピ機能を有するので簡便に再現性のよいエッチングが可能です.
仕様/性能
サムコ社製 RIE-10NR
シリコン系エッチング
対応基板サイズ:最大8インチ
プロセスガス:CF4, SF6, Ar, O2
Deep Si Etcher

概要
仕様/性能
住友精密工業製 Multiplex-ASE
ボッシュプロセス対応
ウエハーサイズ:6 inch
超高密度大気圧プラズマ装置

概要
電子密度1016cm‐3以上(従来比100倍以上)の超高密度な大気圧非平衡プラズマによって,ラジカルを用いた材料の表面処理(改質,洗浄)を高効率に実現.ペン型から幅広型,更にメータ級まで,多様なプラズマヘッドで対応可能.使用ガス:Ar,N2,Ar+O2.
仕様/性能
富士機械製造株式会社
使用ガス:Ar, N2,Ar+O2
電源:AC交流電源,9kV, 60 Hz
真空紫外吸収分光計(原子状ラジカルモニター)

概要
マイクロプラズマ光源を用いた原子状ラジカル(水素H,窒素N,酸素O,フッ素F)絶対密度計測システム.空間分布計測も可能.
仕様/性能
NUシステム社製
ラジカル計測付多目的プラズマプロセス装置
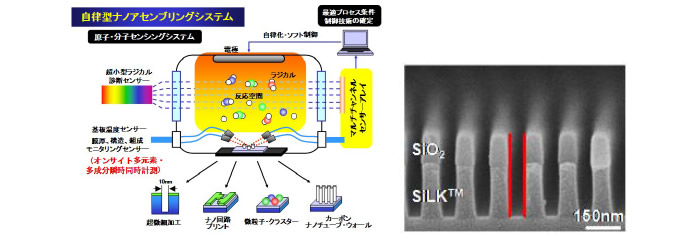
概要
プラズマ中のラジカルやイオンの密度やエネルギーと,基板表面の反応状態を,プロセス中にリアルタイム計測し,フィードバック制御することによって最適なプロセス処理が可能な自律型プラズマナノプロセス装置.有機膜のナノトレンチ加工の例(右).
仕様/性能
東京エレクトロン,プラズマCVD装置
プロセスガス:H2,N2,Ar、O2,He
基板温度:-10℃-60℃
サンプル:最大4インチ
高温プロセス用誘導結合型プラズマエッチング装置
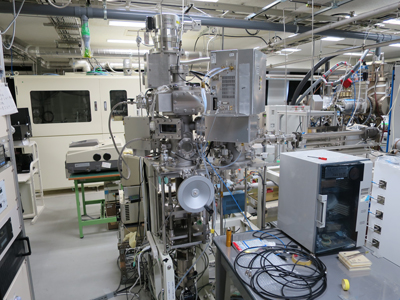
概要
Cl2あるいはBCl3ベースのプラズマエッチングにおいて,高温でのエッチングプロセスが可能です.
仕様/性能
基板温度:200〜600℃
使用ガス:Cl2,Ar,N2,BCl3,O2
表面解析プラズマビーム装置
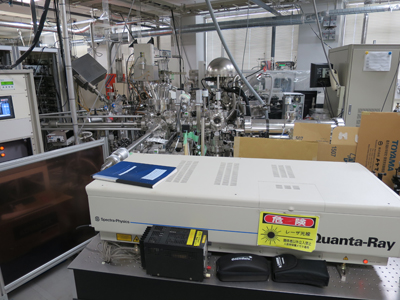
概要
プラズマビームを材料表面に照射し,in-situ XPSによって評価することによって,表面-プラズマ間の反応の解析が可能です. また,イオンおよびラジカルの入射フラックス比を変化させた表面状態の解析も可能です.
仕様/性能
使用ガス:HBr,Ar,CF4,C4F8、Cl2,H2,N2,O2
in-situプラズマ照射表面分析装置
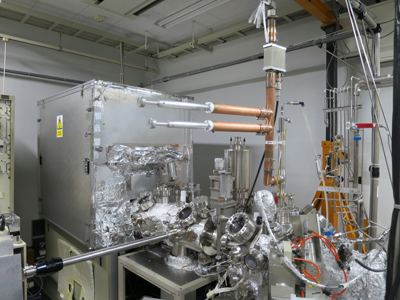
概要
プラズマ照射した表面を大気暴露すること無く,in-situでX線光電子分光法(XPS),フーリエ変換赤外分光光度計(FT-IR),走査型トンネル顕微鏡(STM)によって分析することが可能です.
仕様/性能
プロセスガス:H2,N2,O2,Ar,He,SiH4,SF6,CF4
RIEエッチング装置
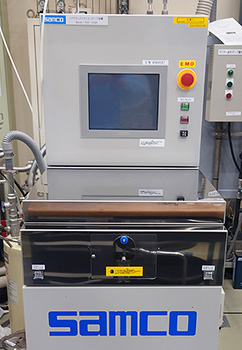
概要
並行平板型反応性イオンエッチング装置でシリコン酸化膜等各種材料を高精度にドライエッチングすることができます.全自動運転でレシピ機能を有するので簡便に再現性のよいエッチングが可能です.
仕様/性能
サムコ社 RIE-10NR
シリコン系エッチング
対応基板サイズ:最大8インチ
プロセスガス:CF4,O2
