���É���w�ݔ��E�@�틤�p���i���u�i�m�e�N�m���W�[�E�v���b�g�t�H�[���v�͔����H�v���b�g�t�H�[���E���\����̓v���b�g�t�H�[���E���q���������v���b�g�t�H�[���̂R�̑����T�C�g�ł��B
���u�ꗗEQUIPMENT
| ���u�� | �d�l | �ݒu�ꏊ | �S���v���b�g�t�H�[�� |
|---|---|---|---|
�}�X�N�A���C�i |
����0.7μm�ȉ��̕s��`�����ɑΉ� | ��[�Z�p�����{�� ����1�K�@�����H�� |
|
�������C�I���G�b�`���O���u |
�G�b�`���O�K�X�FCF4�AO2 ,�����g�d�́F150W |
��[�Z�p�����{�� ����1�K�@�f�o�C�X�v���Z�X�� |
|
�C�I���������u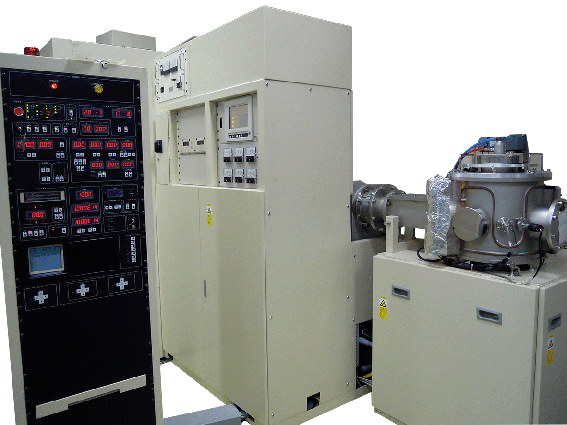 |
�����d���F5-200kV ,�����d��1 µA�`100 µA |
��[�Z�p�����{�� ����1�K�@�f�o�C�X�v���Z�X�� |
|
X�����d�q�������u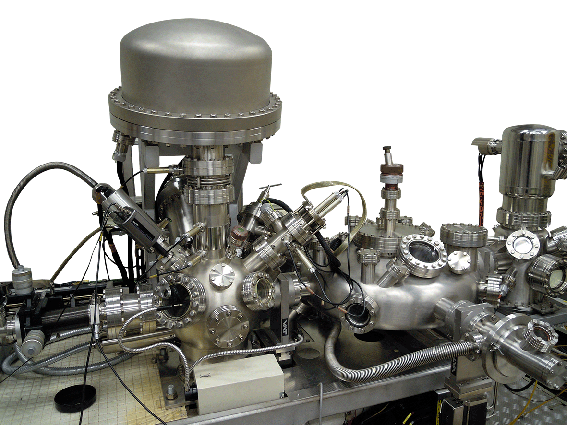 |
�����FMg/Al�c�C���A�m�[�h�����Al���m�N��X����,Ar�X�p�b�^�e�ɂ�鎎���G�b�`���O�\ �p�x���𑪒�p�}�j���s���[�^ |
��[�Z�p�����{�� �V��1�K�@�v�����͎� |
|
�����^�d�q������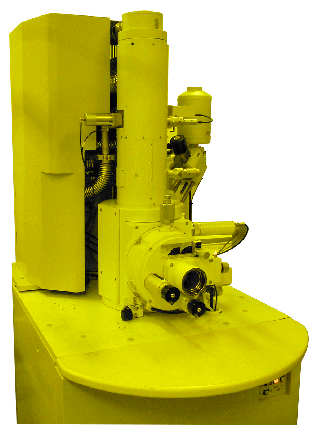 |
�����F��A�ɓd�E���ˌ^�d�q�e, �����d���F0.5�`30kV �{���F10�`500,000,�G�l���M�[���U�^������ɂ��g�����͉\ |
��[�Z�p�����{�� ����1�K�@�����H�� |
|
�d�C�F |
���x�͈́F400-1100�� | ��[�Z�p�����{�� ����1�K�@�f�o�C�X�v���Z�X�� |
|
�}�����M�����u |
���x�͈́F400�`1200�� �������x�F200��/sec |
��[�Z�p�����{�� ����1�K�@�f�o�C�X�v���Z�X�� |
|
����X����ܑ��u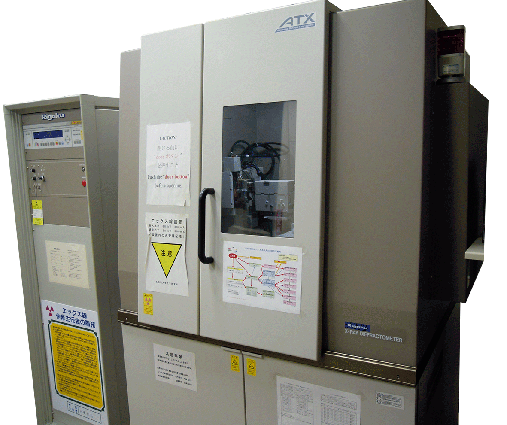 |
Cu Kα�� 18kW�@���w���~���[ Ge���m�N�����[�^�[�t�� ���胂�[�h�Fθ�|2θ�X�L�����C���b�L���O�J�[�u�C�t�i�q�ʃ}�b�s���O�C���ʓ�φ�X�L�����Cφ�|2θχ�X�L�����Ȃ� |
��[�Z�p�����{�� �V��1�K�@�v�����͎� |
|
���q�ԗ͌�����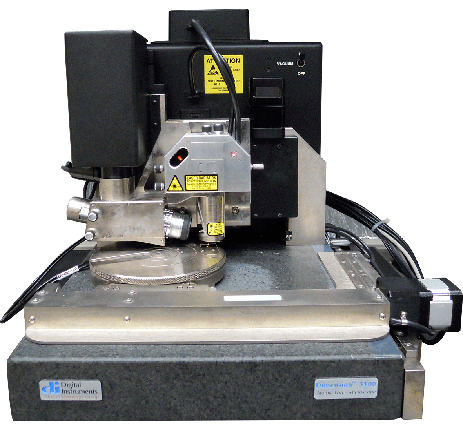 |
�X�L�����̈�FXY�����@��90μm�CZ�����@��6μm �����T�C�Y�F�ő�150 mmφ�|12 mmt ���胂�[�h�@AFM�CMFM�CEFM�CLFM�C�\�ʓd�ʌ������C�d�����C���\�O���t�B�[ |
��[�Z�p�����{�� �V��1�K�@������ |
|
8���}�O�l�g�����X�p�b�^���u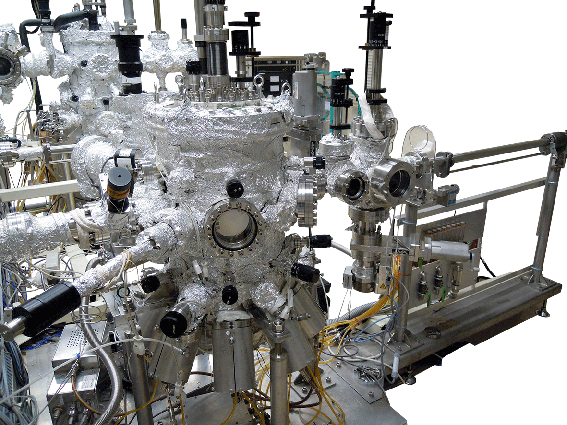 |
2�C���`�J�\�[�h8�{ �����T�C�Y30 mm�p RF�d���@500 W 2�� ����M�F600�� 1 kV Ar�C�I���G�b�`���O�@�\ ������������8�T���v���o���N�� |
��[�Z�p�����{�� �V��1�K�@������ |
|
8��MBE���u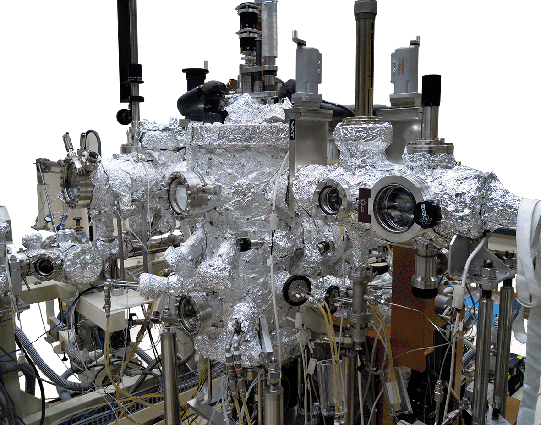 |
�������F4cc������4�A2cc������2�� �����T�C�Y30 mm�p �����d��3�� ����M�F1000�� 1kV Ar�C�I���G�b�`���O�@�\ 25 kV RHEED�\�ʊώ@�@�\ |
��[�Z�p�����{�� �V��1�K�@������ |
|
ECR-SIMS�G�b�`���O���u |
�}�C�N���g����150 W�C�����d��600 V�C�C�I���Ǝˌa30mm ���͎���1-512 amu �����p�x�����C��]�@�\�t�� |
��[�Z�p�����{�� �V��1�K�@������ |
|
3���}�O�l�g�����X�p�b�^���u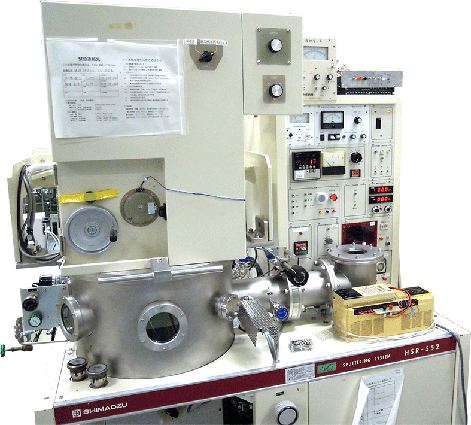 |
4�C���`�J�\�[�h3�{�CRF�d��500 W 2�� �t�X�p�b�^�@�\�C��Չ�]�C�V���b�^�[�J�@�\�ɂ�鑽�w�������\ |
��[�Z�p�����{�� ����1�K�@�f�o�C�X�v���Z�X�� |
|
�I���v���Z�X���u�ꎮ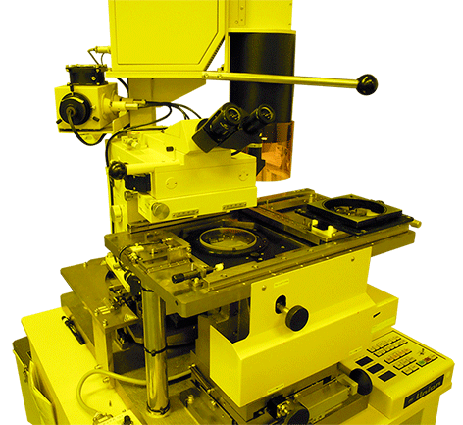 |
���ʘI�����\ �Ή���T�C�Y�F�ő�S�C���` �ŏ��p�^�[���F3.0μm |
��[�Z�p�����{�� ����1�K�@�����H�� |
|
�G�b�`���O�v���Z�X�ꎮ |
�����ٕ����ł�Si�̔����H���\ �Ή���T�C�Y�F�ő�R�C���` ���x���z�F±1�� |
�`������ | |
�����v���Z�X�i���������`���j |
�ʼnY���J�g���j�N�X�А��@CFS-4ES-231 ���������X�p�b�^�A�t�X�p�b�^���\ �������z�F±�T���ȉ� |
��[�Z�p�����{�� ***(***) |
|
�����v���Z�X�i�L�@�����`���j |
���{�p������������А��@PDS2010 ���̓K�����ޗ��̌`�����\ |
��[�Z�p�����{�� ***(***) |
|
���[�U�[�`�摕�u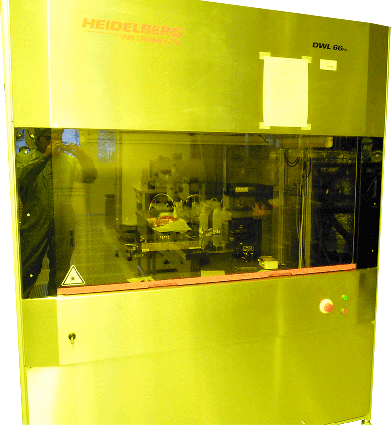 |
�ŏ��`��T�C�Y�F0.6μm �ő�`��T�C�Y�F200mmX200mm ���`����уK���X�}�X�N�쐻 |
VBL �P�K101 |
|
�t�H�g���\�O���t�B���u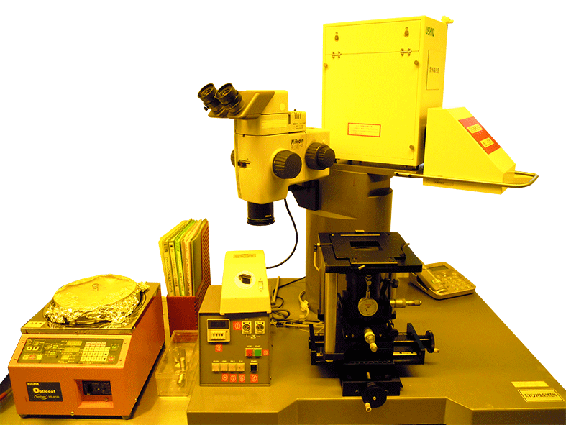 |
�ő�Q�C���`��A�}�X�N�R�C���` �ŏ��p�^���T�C�Y�@�Qμm |
VBL �P�K101 |
|
���q���G�s�^�L�V�[���u |
���Z��8�n���FGa,As,In,Al,Si,Be �Ή���T�C�Y�F�ő�2�C���` RHEED�t |
VBL �P�K101 |
|
�d�q�r�[���������u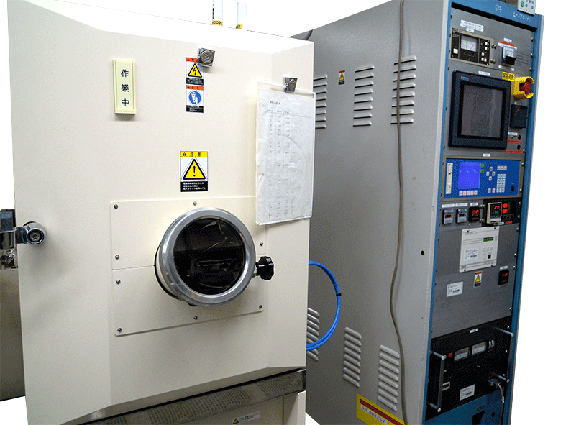 |
�ő哊���d�́F5kW ��ڐ�4�A�n�[�X���C�i�[�g�p |
VBL �P�K107 |
|
�X�p�b�^�≏���쐻���u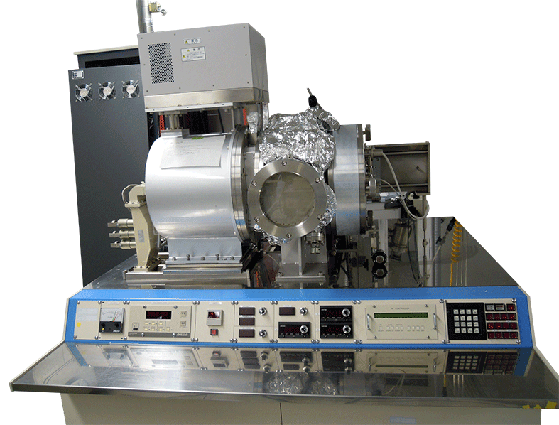 |
�Ή���T�C�Y�F�ő�3�C���` �_�����A�������p |
VBL �P�K107 |
|
ICP�G�b�`���O���u |
�������G�b�`���O �Ή���T�C�Y�F�ő�6�C���`��� �v���Z�X�K�X�FCl2 |
��[�Z�p�����{�� ����1�K�@�f�o�C�X�v���Z�X�� |
|
RIE�G�b�`���O���u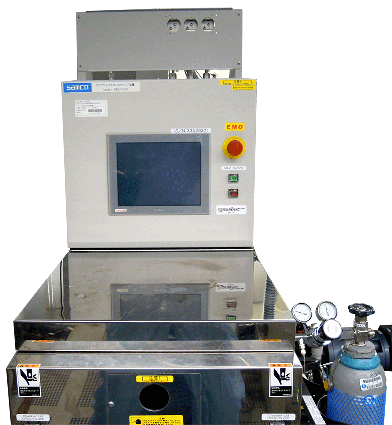 |
�V���R���n�G�b�`���O �Ή���T�C�Y�F�ő�8�C���` �v���Z�X�K�X�FCF4,Ar,O2 |
VBL �P�K107 |
|
�����^�d�q������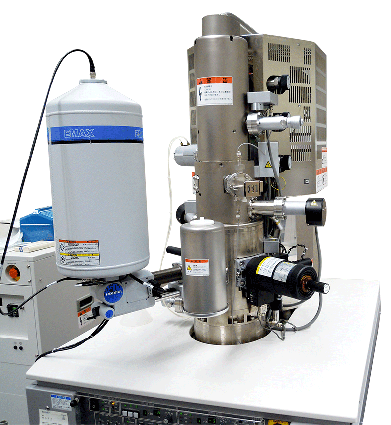 |
�����d���F0.5kV�`30kV ����\�F0.5nm(30kV) �{���F�`2,000,000 �ő厎���T�C�Y�F5mmX9.5mm |
VBL 1�K102 |
|
�i���v |
�G�j�� ��������\�F10nm ���苗���F50μm�`55mm |
VBL �P�K107 |
|
�������x��C���v���Y�}���u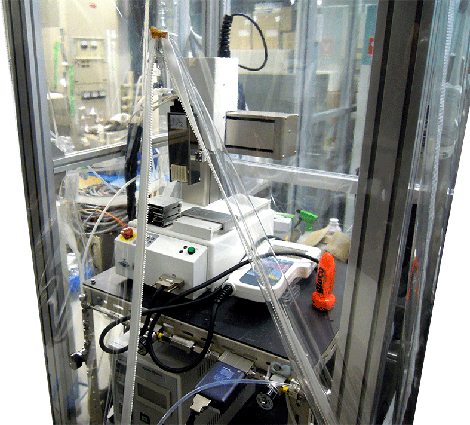 |
��C���v���Y�}���̃��W�J����p�����ޗ��̕\�ʏ����i�����A���j �g�p�K�X�FAr�AN2�AAr+O2 �d���FAC�𗬓d���A�X��V, 60 Hz |
VBL | |
�������x�t���v���Y�}���u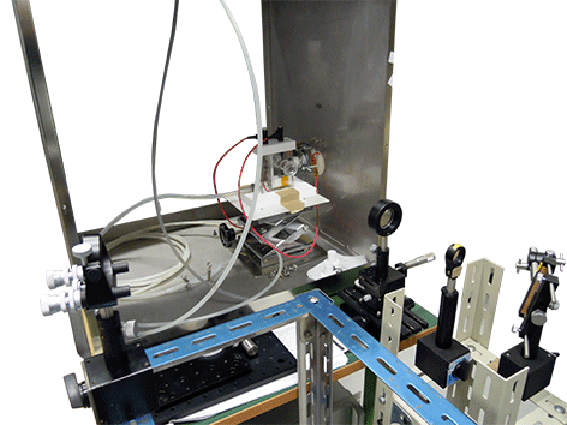 |
�L�@�n�}��p�����i�m�O���t�F������ �t�̕��́A�זE�������\ �d���X��V�A�U�OHz �t�́F�A���R�[���ށ@�T�O�O��L �v���Z�X�K�XAr�@�RL/min |
VBL | |
��C��IAMS(�C�I���t�����ʕ��͊�) |
��C���v���Y�}�̎��ʕ��͂��\ ���o���ʐ��@1-410 |
VBL | |
�^�O�z�������v(���q�W�J�����j�^�[�j |
�v���Y�}�f�f�p�A�^��`�����o�[�ǖʂɐݒu H�AO�AN�AC���W�J�����x�v���� |
VBL | |
In-situ�@�d�q�X�s�����@�iESR)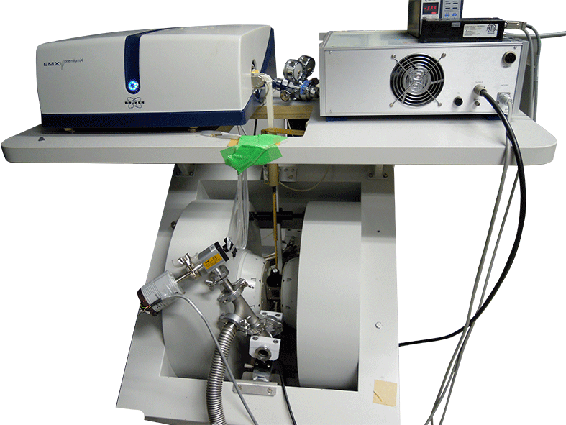 |
�������ɑ��݂���s�Γd�q�̃��A���^�C���v���A���x�ϕs�i�����j�A�C�̕��͉\ �T���v���T�C�Y�F 5 mm ���ȉ��A�Ήp�ǁA�K�X���͉� |
VBL | |
����g��N�v���Y�}�G�b�`���O���u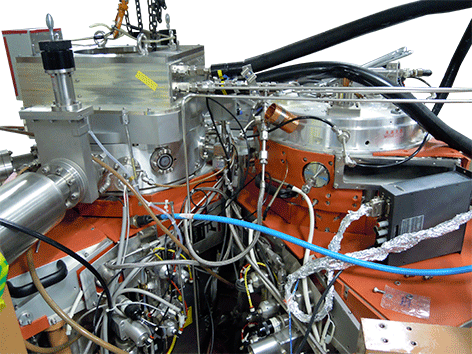 |
������ULSI�����v���Z�X�J���Ɍ������V�K��փK�X�]���Ƃ��̊J�� �v���Z�X�K�X�FFluorocarbon�AAr�AN2�AO2�AH2 �T���v���T�C�Y�FSi�@8�C���`�E�G�n |
VBL | |
60 MHz ��N�v���Y�}CVD���u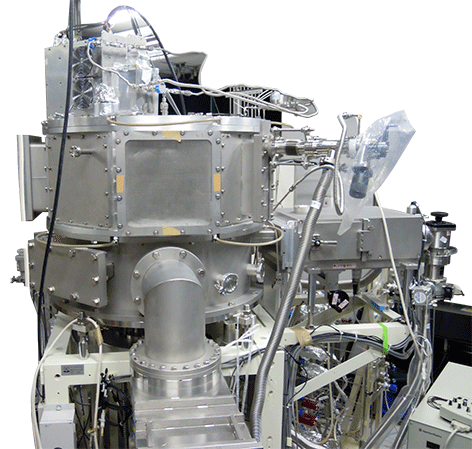 |
�v���Z�X�K�X�F�V�����AN2�A���f�A�A�����j�A�A��K�X�iAr�AHe�j �T���v���FSi�A8�C���` |
VBL | |
���W�J���v���t���ړI�v���Y�}�v���Z�X���u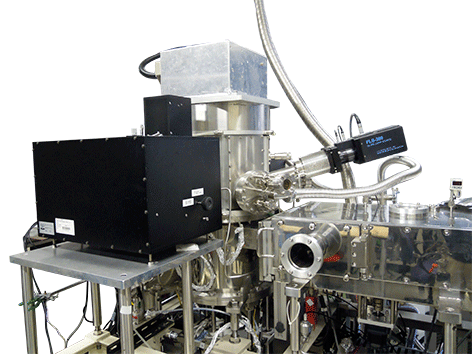 |
����x�A���W�J���A�}���`������AFTIR��p���ăG�b�`���O�̍ۂɐ������鉷�x�A���W�J�����x�A��N��A�\�ʕ��͂�In-situ�ōs���B �v���Z�X�K�X�FH2�AN2�AAr�AO2�AHe ����x�F�|10��-60�� �T���v���FSi�A4�C���`�E�G�n |
VBL | |
���[�U�[�`�摕�u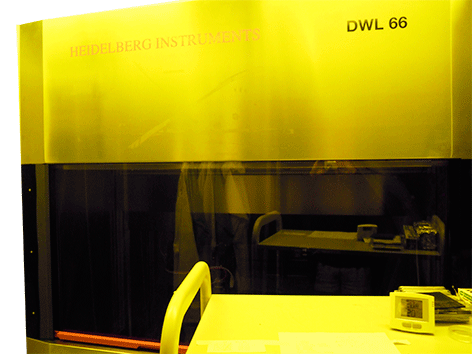 |
�l�d�l�r�̍쐻����тr���G�b�`���O�]���̍ۂ̃}�X�N�쐻 �ŏ��`��T�C�Y�F1.0 μm ���`����уK���X�}�X�N 50 mm x 50 mm |
VBL | |
| ���C�����]���V�X�e���Q ��Ԏ��E���z�^���͌v 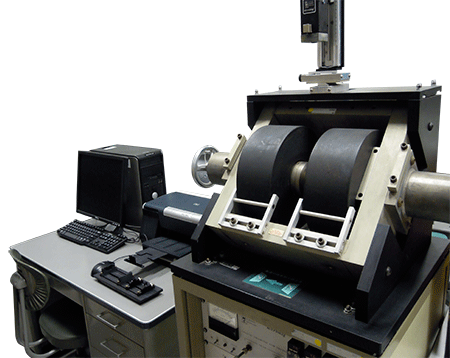 |
���x10^-8emu�C20kOe | ��c������ | |
| ���C�����]���V�X�e���Q �U�������^���͌v 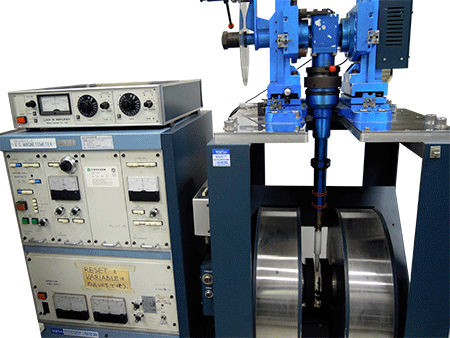 |
���x10^-5emu�C15kOe | ��c������ | |
| ���C�����]���V�X�e���Q �g���N���͌v 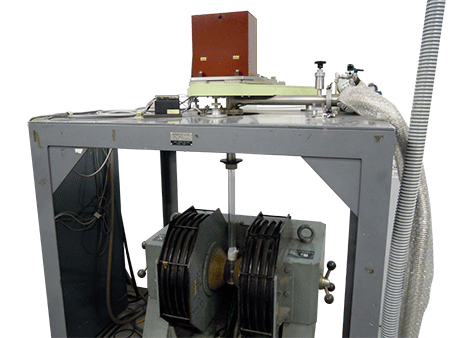 |
2×10^-3erg�C15kOe | ��c������ | |
| ���C�����]���V�X�e���Q ���C���w�X�y�N�g�����[�^  |
2×10^-3deg�C16kOe | ��c������ | |
���ʘI���p�}�X�N�A���C�i�iSuss MA-6�j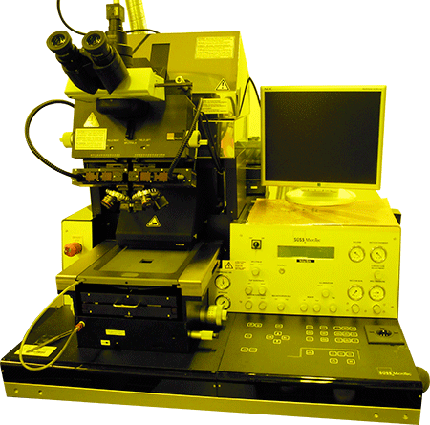 |
�Ή��T�C�Y: Φ2inch - 150 mm�C �s��`���ЁF150 mm �A���C�����g���x: ±0.5 mm(�\�ʱײ���), ±0.1 mm(���ʱײ���), |
��[�Z�p�����{�� ����1�K�@�����H�� |
|
���ʘI���p�}�X�N�A���C�i�iSuss MJB-3�j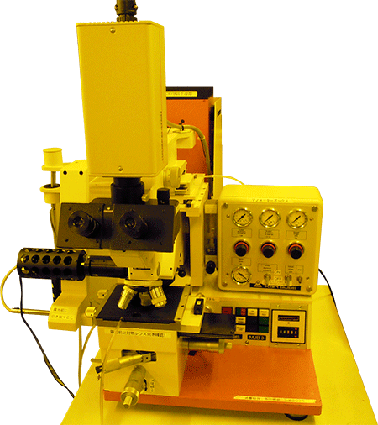 |
�ő�E�F�[�n�T�C�Y�F 3 inch�i�z�����[�h�j 4 inch�i�\�t�g�R���^�N�g�j �Ǝ˔͈́F3×3 inch �Ή�������F4.5 mm |
�V�䌤���� | |
�}�X�N�A���C�i�iLA410�j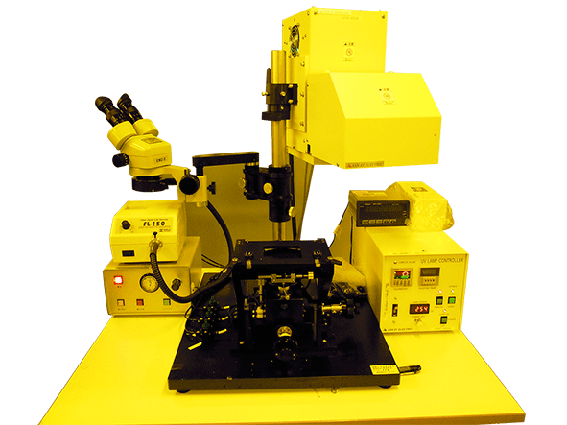 |
�K���}�X�N�F�ő�@5 inch �K�������F�ő�Φ4 inch |
�V�䌤���� | |
�X�v���[�R�[�^�[�ꎮ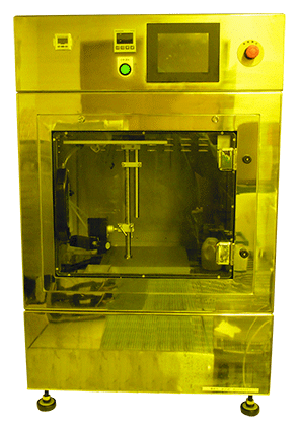 |
�Ή��T�C�Y:�ő� ��220 mm �ړ��͈�:�c��300 mm �ړ����x:10�`200 mm/�b ���q�a:��5�`15 mm �N���[���u�[�X�@CLB���ɐݒu |
��[�Z�p�����{�� ����1�K�@�����H�� |
|
���[�U�`�摕�u�ꎮ |
�Ή���F100 ×100 mm ���H���x�F1 mm �Ή��f�[�^�FDXF�CCIF�CBMP |
�V�䌤���� | |
�X�p�b�^�����O���u�ꎮ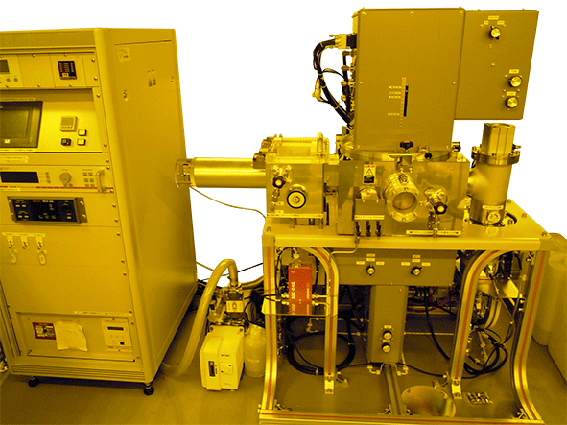 |
�^�[�Q�b�g�FSiO2�CCr�CAu �������z�FΦ100 mm��±3�� ��z���_�[�FΦ200 mm ����M�FMax 300���i����t�j |
�V�䌤���� | |
3�������[�U�E���\�O���t�B�V�X�e���ꎮ |
Nanoscribe���@̫�Ư�����̪����� 2�������H���x�F100 nm 3�������H���x�F150 nm �Ή��f�[�^�FDXF, STL |
�V�䌤���� | |
3�������[�U�E���\�O���t�B�V�X�e���ꎮ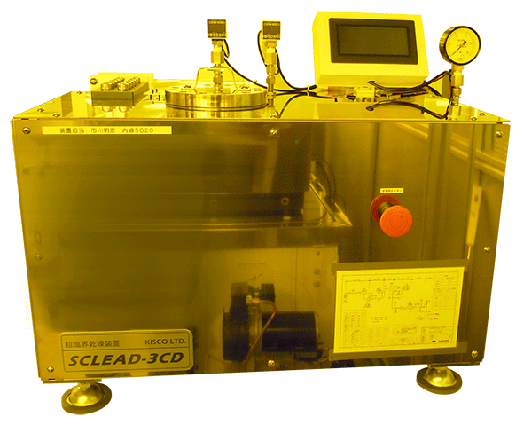 |
KISCO���@SCLEAD3CD2000 �v���x�F100 �� �v���́F20 MPa �O���F900×600×1200 mm |
�V�䌤���� | |
���O�������`���u�ꎮ |
���`���x�F16 mm ���`�T�C�Y�F260 mm×260 mm×200 mm�@ |
�V�䌤���� | |
�i�m�C���v�����g���u�ꎮ |
�`���F�M���CUV�� �ő像�[�N�T�C�Y�FΦ150�@mm �ő�d�F50�@KN �ō��d�l���x�F250���C650�� UV�@�\�F�g�� 365 nm�^385 nm �L���Ǝ˖ʐρF��100 mm |
�V�䌤���� | |
�p�������R�[�e�B���O���u�ꎮ |
�����`�����o�[���@�FID300×H350 mm | �V�䌤���� | |
���^���`��@�ꎮ |
�@ | �V�䌤���� | |
�u���o�C�I�C���[�W���O���u�ꎮ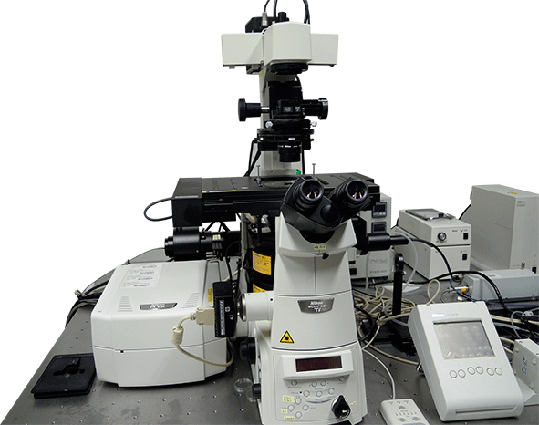 |
���œ_���[�U�������V�X�e���@ �u����N���[�U�F 405 nm�C488 nm�C561 nm�C635 nm �Ε������Y�F100�{�C10�{�C20�{ |
�V�䌤���� | |
ICP�G�b�`���O���u�ꎮ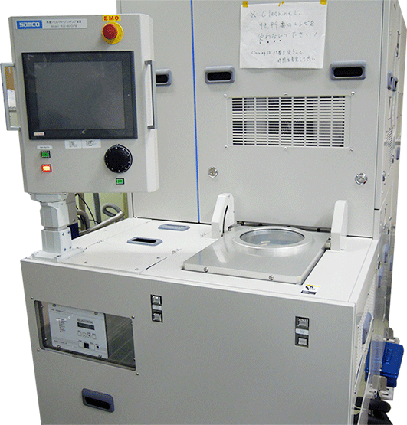 |
�E�F�[�n�T�C�Y�F6 inch �{�b�V���v���Z�X�Ή� ���H���x�F50 mm/min |
��[�Z�p�����{�� ����1�K�@�f�o�C�X�v���Z�X�� |
|
ECR�X�p�b�^�����O���u�ꎮ |
���ޯĻ��ށF100 mm×80 mm �����d���F100 V�`3000 V ����ްїL���a�FΦ20 mm |
�V�䌤���� | |
�d�����u�ꎮ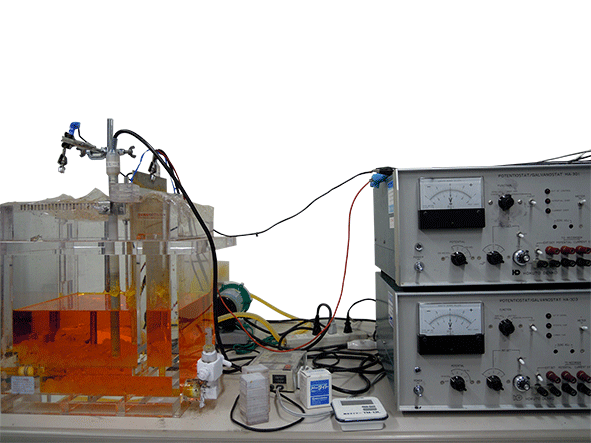 |
���b�L��ށF�� �E�F�[�n�T�C�Y�FΦ3-12 inch �E�F�n�ގ��FSi/�K���X�� |
�V�䌤���� | |
�����x�d�q���`�摕�u�ꎮ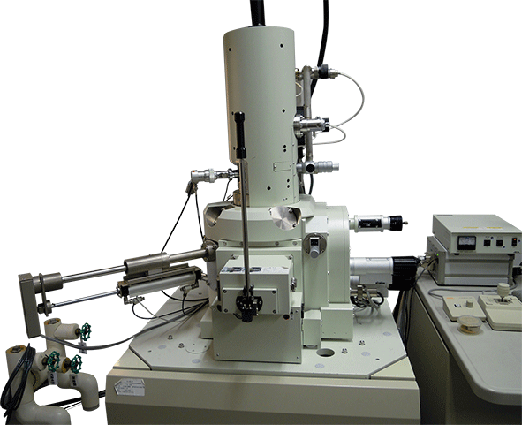 |
�⏞����\�F1.2 nm(30kV) �{���F×10�`×1,000,000 �������F�ő�200 mm JSM-7000FK�ɓ��� |
�V�䌤���� | |
SEM�p�f�ʎ����쐻���u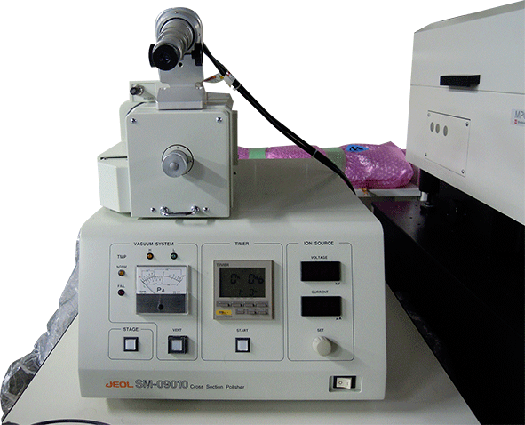 |
�ő哋�ڎ����T�C�Y�F �C�I���r�[���a�F500 mm �����ړ��͈́F±3 mm ×±3 mm |
�V�䌤���� | |
�f�W�^���}�C�N���X�R�[�v�ꎮ |
����\�F���������@0.01 mm ���������@0.13 mm �ő�ώ@�{���F3,000�{ ����p�����F�g���@408 nm |
�V�䌤���� | |
�d�q���I�����u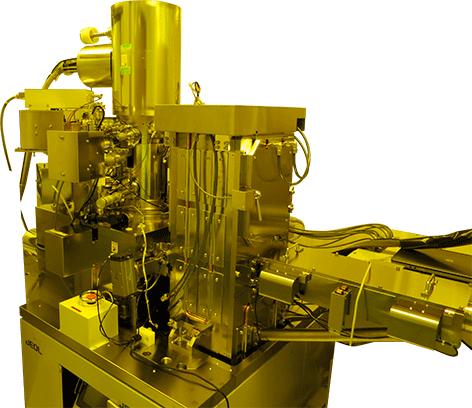 |
���{�d�q�А��@JBX6300FS �����d���F25 / 50 / 100kV �ŏ��r�[���a�F2 nm �r�[���d���F100 pA - 2 nA �d�ˍ��킹���x�F9 nm |
��[�Z�p�����{�� ����1�K�@�}�X�N�� |
|
�t�F���g�b���[�U�[���H���̓V�X�e�� |
�P�n�А��@UFL-Hybrid �����F1041 nm, 550 fs, 10 µJ (IMRA µjewel D-1000) �����g�������j�b�g�F40% @520 nm, 5% @347 nm (���H�X�e�[�V����) �ő厎�����@�F100 mm x 100 mm ���H�X�|�b�g�F3.5 µmφ (���̓X�e�[�V����) ���ԕ����u���E���C���́E�����f�w�B�e |
��[�Z�p�����{�� ����1�K�@������ |
|
X�����d�q�������u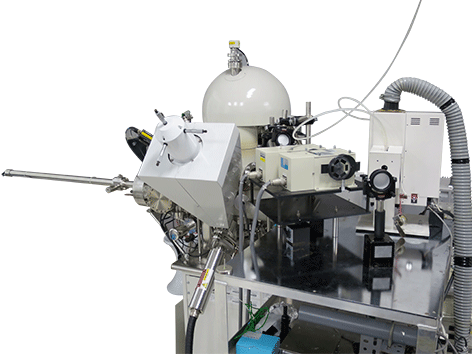 |
VG�А��@ESCALAB210 �����FMg/Al�c�C���A�m�[�h�����Al���m�N��X���� Ar�X�p�b�^�e�ɂ�鎎���G�b�`���O�\ �p�x���𑪒�p�}�j���s���[�^ | �V�䌤���� | |
�t�[���G�ϊ��ԊO�������͑��u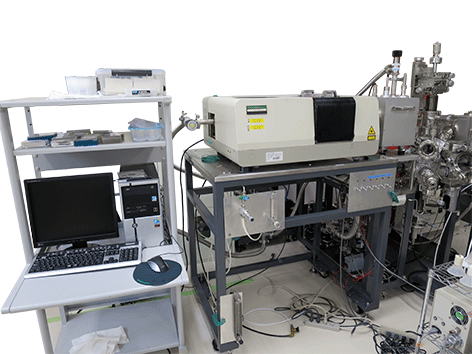 |
����\�F���������@0.01 mm ���������@0.13 mm �ő�ώ@�{���F3,000�{ ����p�����F�g���@408 nm |
�k��1�K | |
| �A���o�b�N�А��@CE-300I �������G�b�`���O �Ή���T�C�Y�F�ő�6�C���`��� �v���Z�X�K�X�FCl2 | ����5�K |
||
�v���Y�}CDV���u |
�T���R�А��@PD-240 ����M�F��R���M�� (�`400��) �K���E�F�n���@�F�s��`�`3�C���`�a �����g�d���F�ő�300 W�i13.56 MHz�C�������䎮�j �����K�X�FTEOS, O2�CCF4 |
��[�Z�p�����{�� ����1�K�@�f�o�C�X�v���Z�X�� |
|
�_�C�V���O�\�[���u |
�T���R�А��@DAD522 �ő像�[�N�T�C�Y�FΦ152.4 mm �؍�\�͈́iXY�j�F220 mm×160 mm �L���X�g���[�N�iZ�j�F27.2�@mm ��]�p�F380° �A���C�������g�p�Ε������Y�F100�{ |
��[�Z�p�����{�� ����1�K�@�f�o�C�X�v���Z�X�� |
|
���A�N�e�B�u�C�I���G�b�`���O���u |
�u �T���R�А��@RIE-10N �Ή���T�C�Y�F�ő�8 inch �v���Z�X�K�X�FCF4�CSF6�CO2�CAr �d�Ɍa�F210 mmφ �ő�RF�d�́F�@300 W |
��[�Z�p�����{�� ����1�K�@�f�o�C�X�v���Z�X�� |
|
�v���Y�}�x�����q�w�͐ϑ��u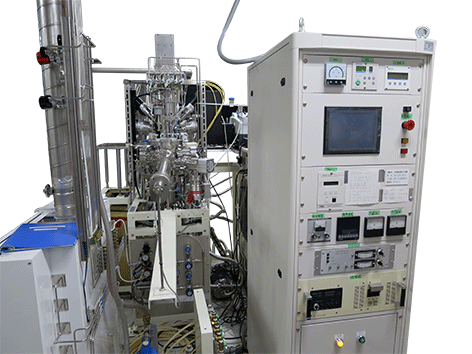 |
�v���Y�}��p���Č��q�w�ł̖��͐ς��\ �������̖��������̏�Ein-situ FTIR�ŕ]�����邱�Ƃ��\ ����x�F20?600�� �g�p�K�X�FSiH4�CAr�CN2�CH2�CO2 |
||
�����v���Z�X�p�U�������^�v���Y�}�G�b�`���O���u |
Cl2���邢��BCl3�x�[�X�̃v���Y�}�G�b�`���O�ɂ����āC�����ł̃G�b�`���O�v���Z�X���\ ����x�F200?600�� �g�p�K�X�FCl2�CAr�CN2�CBCl3�CO2 |
||
�\�ʉ�̓v���Y�}�r�[�����u |
�v���Y�}�r�[�����ޗ��\�ʂɏƎ˂��Cin-situ XPS�ɂ���ĕ]�����邱�Ƃɂ���āC�\��-�v���Y�}�Ԃ̔����̉�͂��\ �C�I������у��W�J���̓��˃t���b�N�X���ω��������\�ʏ�Ԃ̉�͂��\ �g�p�K�X�FHBr�CAr�CCF4�CC4F8�ACl2�CH2�CN2�CO2 |
||
in-situ�v���Y�}�Ǝ˕\�ʕ��͑��u |
�v���Y�}�Ǝ˂����\�ʂ��C�\�I���邱�Ɩ����Cin-situ��XPS�CFT-IR�CSTM���͂��邱�Ƃ��\ �v���Z�X�K�X�FH2�CN2�CO2�CAr�CHe�CSiH4�CSF6�CCF4 |
||
| �����Ȋw������ �������ߓd�q������  |
�ō������d���G 1000kV ����\�G ��0.15 nm |
||
| ������\�d�q��Ԍv�� ���쓧�ߌ^�d�q������ JEM-ARM200�iCold) (������d�q������  ) ) |
TEM�_����\�F0.19nm STEM�@�\�v���[�u�a�F�L��60pm �Ǝ˃����Y�n�Ɏ�����@�\�𓋍� �����d���F 200,80kV ��d�E���o�d�q�e TEM, STEM, EDS, EELS |
||
| �d�E���o���� ���ߓd�q������ JEM-10000BU (������d�q������  ) ) |
TEM�_����\�F0.11nm STEM�@�\�v���[�u�a�F�L��70pm �Ǝ˃����Y�n�A���������Y�n�̂��ꂼ��Ɏ�����@�\�𓋍� �����d���F 200,80kV �d�E���o�d�q�e TEM, STEM, EDS, EELS �d�q���z���O���t�B�[ |
||
�d�q�����������ߓd�q������EM2100M 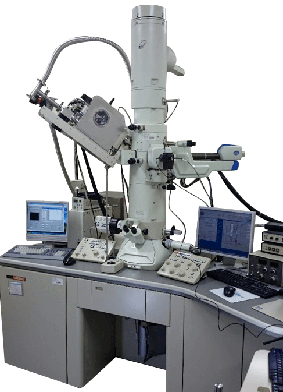 |
TEM�_����\�F0.23nm STEM�@�\�L �v���[�u�a�F1.0nm �����d���F200kV EELS, EDX�A�g�����UX�������� �J�\�[�h���~�l�b�Z���X(CL) 100K-1000K�̉��x�͈͂Ōv���� |
||
| �d�E���o���ߓd�q������ HF-2000 (�z���O���t�B�[�d�q������) 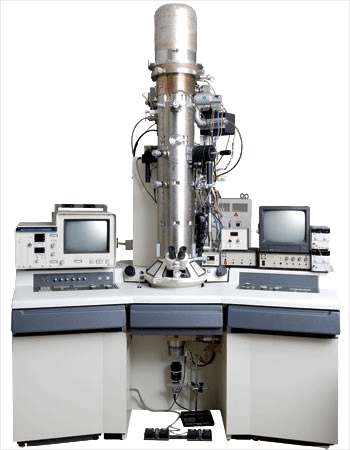 |
TEM�_����\�F0.23nm �����d���F200kV �_�f�A���f�K�X������ ���C�V�[���h�����Y��p����Ǝ����ޗ����ώ@��(�ő�50���{) ��d�E���o�d�q�e |
||
������\���͓d�q������JEM-2010F  |
TEM�_����\�F0.19nm STEM�@�\�L �v���[�u�a�F1.0nm �����d���F80/120/160/200kV ���f���́FEDX �d�E���o�d�q�e |
||
�����d�q������Quanta200FEG  |
�����d���F0.2�`30 kV �d�q������\�F2 nm �i30 kV�GESEM���[�h�A���^�[�h�j 3.5 nm (3 kV�F��^�[�h) �}�C�N���}�j�s�����[�^�F2��� �G�l���M�[���U�^X�����͑��u ���M�X�e�[�W�F�����`1300�� |
||
| �������H�ώ@���͑��u MI-4000L (FIB-SEM) 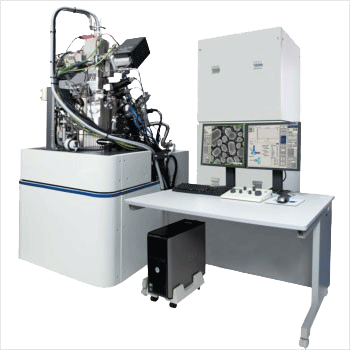 |
�����d���F30kV (FIB, SEM) �}�C�N���T���v�����O�@�\ FE-SEM�AEDS �����EDSD�@�\ |
||
| �W���C�I���r�[�����H�@ FB-2100(FIB) |
�����d���F40kV �}�C�N���T���v�����O�ACAD�@�\ |
||
| �A���S���C�I���������u PIPS�U |
�C�I���e�F��G�l���M�[�W���d�Ƀy�j���O�C�I���e 2�� �C�I���G�l���M�[�F100eV�`8keV XY��ւ��͈́F±0.5���� ��p�X�e�[�W�F�t�̒��f(�ێ�����6�`7����) |
||
| �����C�I���~�����O���u | �����d�� 100V �` 6.0kV �C�I���d�����x�F10mA/cm2�i�s�[�N�j �~�����O�p�x�F�{10°�`�|10° |
||
| �J�[�{���R�[�^�[ | �����x�Y�f�@�ێg�p �R�[�h���ԁF1.95�b �v���Y�}���d���ԁF15�b |
||
| �_�C�������h���C���[�\�[ | ���C���[�Ԋu�T�C�Y�F60 �o ���C���[�ؒf���S�X�C�b�`���� ���C���[�a�Fφ100�`300μm �_�C�������h���a�F20�`60μm |
||
| �I�X�~�E���R�[�^�[ Neoc-Pro | �`�����o�[���@�Fφ150×70 mm |
||
���[�U�[���}���������x�v |
�����V�X�e���i��ԕ���\�F2μm�j ����\�͈́F50�`4000 cm-1 �V���O�����m�N�����[�^�[ �E���ڃ��[�U�[�F�O���[�����[�U�[, 532nm, 10mW |
�@�핪�͎� | |
| �S�������f���͑��u | ���茳�f C, H, N (CHN���[�h) ������� �J������������(�t�����^���N���}�g�O���t�B)�ATCD���o �R�ĕ��� ���_�f���̐ÓI�R�� |
�@�핪�͎� | |
| �����P����X���\����͑��u | ����\��X���W���~���[����,�P�x�F31kW/mm2, �d���J�������ϋ@�\�i25-110mm),CCD���o��i70mmx70mm),Mo����, χ���Œ�,������������p���u�i-180�� ? ����) |
1����2�K233 | |
| X��������ܑ��u | �ő�o�́F9kW ���o��F�V���`���[�V�����J�E���^�[�A������1�������o��A�����o�� Cu�^�[�Q�b�g ���������z�u |
���{������ | |
| �u��X�����͑��u | �G�l���M�[���U�^ �ő�o�́F50W �^�[�Q�b�g�FCu�AMo�AAl�ARX-9 ���o��FSilicon Drift Detector �����T�C�Y�Fφ20 |
���{������ | |
| ���a���葕�u | ����Z�x�͈� �F0.001 % �` 10 % �[�[�^�d�� �F-200 �` 200 mV �d�C�ړ��x �F-20×10 -4 �` 20×10 -4 cm2/V�Es ���q�a �F0.6 nm �` 7000 nm�@�@ ���x �F10�`90 �� ����\�T���v���F�����q���U�t pH�^�C�g���[�^�[���� ���w�n�F���[�U�[�h�b�v���[�@ |
�����J������ | |
| �����^�d�q������ | �d�E���o�`�d�q�e�@ �d�q����\�F1.0nm�i15kV�j�A1.4nm�i1kV�j �{���F×25�`1,000,000�@�����d���F0.1�`30kV�@�E�W�F���g���r�[�� �I�v�V�����F���g���N�^�u�����˓d�q���o��(RBEI)�A�G�l���M�[���U�`X�����͑��u(EDS) |
1����2�K233 | |
| �d�q�X�s�������u | ����g���F8.800�`9.600 MHz ���x�F7 × 109 / 0.1 mT�i100 kHz ����ϒ��ɂāA�ő�o�� 200 mW�j ����\�F100 kHz ����ϒ��ɂāA4 mm × 43.5 mm �� 2.35 uT �ȏ� |
1����1�K108 | |
| �G���N�g���X�v���C���ʕ��́iESI-MS�j | �C�I�����FESI ���͌v�F���t���N�g�����i������s�����F��2.0nm�j ���o��F400mmφ2�iMCP ����\�F6000�iFWHM�j ���ʔ͈́F10000�@ ���ʐ��x�F5ppm�iPEG, ���Z���s���j�@ �R�[���h�C�I���X�v���[������ |
1����9�K928 | |
| �}�g���b�N�X�x�����[�U�[�E���C�I������s���Ԍ^���ʕ��͑��u | ���莿�ʔ͈́F1�`500000Da�i���j�A���[�h�j/1�`60000Da�i���t���N�g�������[�h�j ���ʕ���\�i���l���j�F4000�ȏ�i�ő�, Insulin B chain, ���j�A���[�h�j/20000�ȏ�i�ő�, Insulin, ���t���N�g�������[�h�j ���ʐ����x�i�����W���j�F100ppm�ȓ��i���j�A���[�h�j/10ppm�ȓ��i���t���N�g�������[�h�j |
1����9�K928 | |
NMR(500MHz)���u |
Agilent���@UNITY INOVA 500 | �@�핪�͎� | |
| NMR(700MHz)���u | Agilent���@UNITY INOVA 700 | �@�핪�͎� | |
| �ő�NMR(300MHz)���u | �a�q�t�j�d�q���@AVANCE 300Wbs | 1����1�K110 | |
�����q�i�m�����̖�������i�ȈՌ��q�ԗ͌������j |
SII�А��@NPX2100 | ������ | |
| �����\�ʊώ@�i���q�ԗ͌������j | Asylum�А��@MFP-3D | ������ | |
| ���O���z���������u/���w�A�^�b�`�����g | Agilent�А��@8453 | ������ | |
�J�X�^�}�C�YXRD���u�i��{X���U�����uFR-E�jFR-EFR-E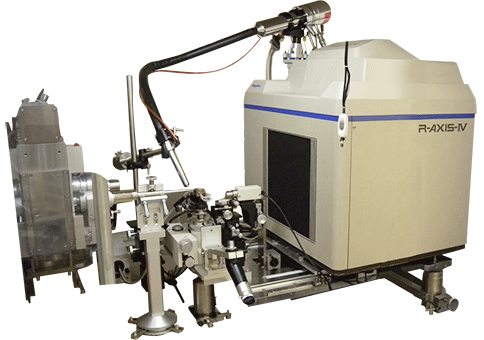 |
Rigaku�А��@FR-E | ������ | |
| �d�q�~��F�� | JASCO�А��@ECD�@J-820 | ���������� | |
| �d�q�~��F�� | JASCO�А��@ECD�@J-702YS | ���������� | |
| �U���~��F�� | JASCO�А��@VCD�@JV-2001YS | ���������� | |
| �g�U���ˉ~��F���������u | JASCO�А��@DRCD�@PCD-466 | ���������� | |
| �t�̃N���}�g�O���t�B�[ | JASCO�А� | ���������� | |
| �~��F�����o�� | JASCO�А��@CD-2095 Plus | ���������� | |
| �������o�� | JASCO�А��@OR-1590 | ���������� | |
| �������o�� | JASCO�А��@OR-2090 Plus | ���������� | |
| �}���`���O�E�����o�� | JASCO�А��@MD-2010 Plus | ���������� | |
| 500MHz NMR���u | Varian�А��@OXFORD AS500 | ���������� | |
| ���q�ԗ͌����� | Veeco Instruments�А��@AFM Nanoscope IIIa | ���������� | |
| �M�d�ʑ��葕�u | SII�А��@TG TG/DTA6200 | ���������� | |
| ���������M�ʑ��葕�u | SII�А��@DSC DSC6200 | ���������� | |
| �t�[���G�ϊ��^�ԊO�������u | JASCO�А��@FT-IR,FT-IR-680 Plus | ���������� | |
| �u���������x�v | JASCO�А��@FP-6500 | �n�ꌤ���� | |
| �z���������x�v | Shimadzu�А��@UV-1800 | �n�ꌤ���� | |
| ���I���U���iDLS�j | Malvern�А��@Zetasizer Nano ZS | �n�ꌤ���� | |
| �ڐG�p�v | ���a�E�ʉȊw�А��@DM-501 | �n�ꌤ���� | |
| ���𑜌����� | Leica�А��@TCS STED CW | �n�ꌤ���� | |
| ���𑜌����� | Carl Zeiss�А��@Elyra PALM system | �n�ꌤ���� | |
| �i�m�o�C�I���q�����E���𑜉�͕]���V�X�e�� | �n�ꌤ���� | ||
| �u���������d�C�j���V�X�e�� | Nikon�А��@TE300 | �n�ꌤ���� | |
| �S���ˌu�������� | Olympus�А��@IX71 | �n�ꌤ���� | |
�`�b�v�d�C�j�� |
Agilent�А��@Bioanalyzer | �n�ꌤ���� | |
| �`�b�v�d�C�j�� | Shimadzu�А��@MultiNA | �n�ꌤ���� | |
| �����M�E�g�U�V�~�����[�V���� | Coventor�А��@CoventorWare | �n�ꌤ���� |
