マイクロ・ナノ構造体の作製と評価
~FIBによる微細加工とTEMによる高分解能観察~
| 工学研究科・マイクロ・ナノ機械理工学専攻・バイオロボティクスGr | 准教授 丸山央峰 |
集束イオンビーム(FIB)による微細加工
試料表面に集束イオンビーム(Focused Ion Beam: FIB)を走査しながら照射して,薄膜デバイスをはじめ多種多様の材料の高分解能観察・加工・各種試料作製を行うことができます.具体的には,走査イオン顕微鏡として,試料表面の高分解能観察やFIB照射による試料表面のエッチング加工,試料表面にカーボンまたはタングステン薄膜を形成するデポジション加工を行えます.

FIB装置の外観
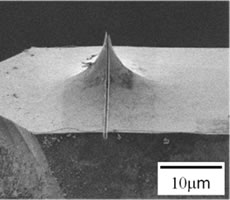 加工例:マイクロ波原子顕微鏡プローブ探針のスリット加工
加工例:マイクロ波原子顕微鏡プローブ探針のスリット加工透過型電子顕微鏡(TEM)による高分解能観察
試料に電子線を照射し,透過電子を結像して,拡大・高分解能観察することができます.ただし,試料の厚みを約100ナノメートル以下に薄片化する必要があります.このために上記の集束イオンビーム(FIB)による微細加工を利用することができます.
本透過型電子顕微鏡は,EDS(Energy Dispersion Spectroscopy,エネルギー分散型X線分光分析)装置を備えているため,元素分析をすることも可能です.高分解能観察と組み合わせることにより,例えば新材料の結晶状態や元素分析など多角的な材料評価を行うことができます.
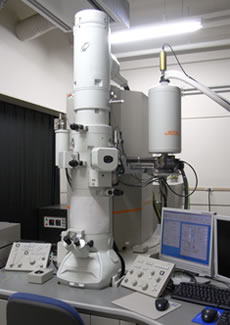
TEM装置の外観
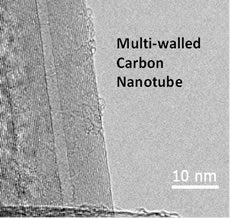 多層カーボンナノチューブの高分解能観察例
多層カーボンナノチューブの高分解能観察例名古屋大学工学研究科・マイクロ・ナノ機械理工学専攻 丸山央峰
Tel. 052-789-4493, Fax. 052-789-5213
E-mail : hisataka![]() mech.nagoya-u.ac.jp
mech.nagoya-u.ac.jp
