成膜装置
8元マグネトロンスパッタ装置
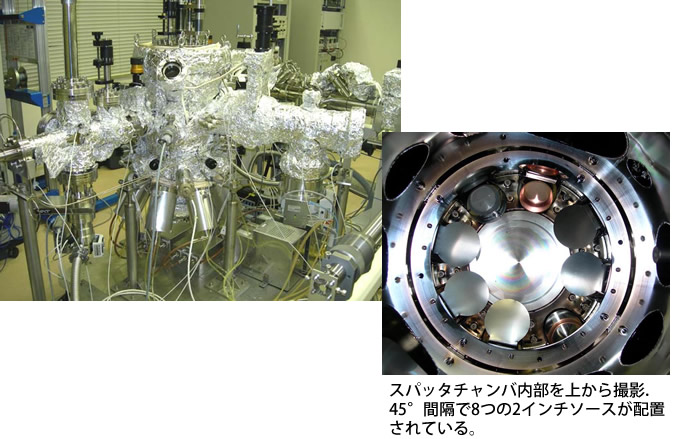
概要
本装置は,8つの2inchターゲットを備えた超高真空仕様のマグネトロンスパッタ装置です.8種類の元素/合金をナノメートルの精度で積層することができるため,複雑な膜構成のトンネル磁気抵抗効果膜やスピンバルブ膜などを作製することができます.
仕様/性能
研究室による自作
到達真空度:8×10-8 Pa
2インチカソード8台
試料サイズ30mm角以下
RF電源 2台 直流電源 1台
基板加熱機構(<600 ℃)
1kV-Arイオン銃による基板クリーニング機構
同時スパッタリングによる合金層作製機能
利用可能スパッタガスAr,O2
ロードロック機構
ECR-SIMS室,及び8元MBE装置への超高真空中基板搬送機構
8元MBE装置

概要
本装置では,分子線エピタキシー(MBE)法による磁性薄膜,磁性人工格子の成長を行うことができます.8つの電子ビーム加熱源を用いることで,スピンエレクトロニクスに利用される複雑な膜構造を作製することができます.
仕様/性能
アネルバ社製(特注)
到達真空度:1×10-8 Pa
蒸着源:電子ビーム加熱8元,電源3台
2源同時蒸着による合金薄膜の作成機能
RHEED観察機能,基板加熱<1000℃
Arイオン銃による基板クリーニング機構
水晶モニターとシャッター制御による人工格子作製機能
基板ロードロック機構およびECR-SIMS室,8元スパッタ装置への超高真空中基板搬送機構
3元マグネトロンスパッタ装置
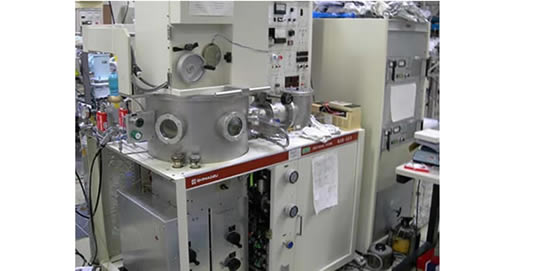
概要
本装置は,3つの4inchターゲットを備えていおり,熱磁気記録用の媒体や巨大磁気抵抗効果を示す多層膜など,金属の多層膜を作製することができます.また,SiN, SiO2,Al2O3などの誘電体材料の薄膜の作製も可能です.ロードロック室を備えないバイトンゴム・シールの高真空の装置であるため,ターゲット交換も容易です.特定の材料のスパッタ成膜を試したい場合など,比較的手軽に利用することができます.
仕様/性能
島津製作所HSR-522
4インチカソード3本,RF電源500 W 2台
逆スパッタ機構,基板水冷機構,基盤回転,
シャッター開閉機構による多層膜成長可能
電子ビーム蒸着装置
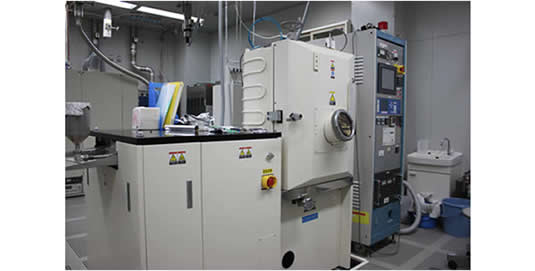
概要
4連電子ビーム蒸着源なので多層膜が成膜できます.ハースライナーを使用しますので,各種金属,絶縁物を蒸着することができます.高性能成膜モニターを装備し,0.1nmの膜制御が可能です.
仕様/性能
アルバック社製 EBX-10D
最大投入電力:5kW
るつぼ数:4 (2.9cc)
基板サイズ:50mm X 50mm
膜厚レート分解能:0.0055Å
真空排気系:TMP
スプレーコーター
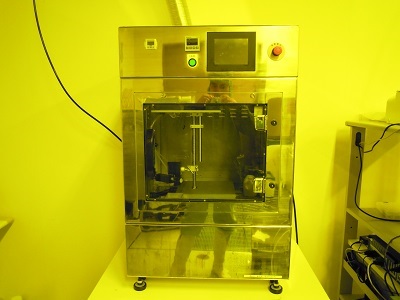
概要
本装置はMEMSデバイス,及び各種半導体研究用に開発されたスプレーコーターです.微細粒子化が可能なスプレーノズルにより,基板上の傾斜面,台形や直角頂点部といったスピンコータでの塗布が困難であった部分に均一な膜を形成できます.また,スピンコータでは困難であったキャビティ,ビアホール,トレンチ構造へのレジスト埋め込み塗布も可能です。
仕様/性能
サンメイ製 DC110
対応膜厚:1μm~600μm (薬液特性に依存)
試料台サイズ:DC110:220×220mm □
ノズル移動範囲:縦横300mm
ノズル移動速度:10~300mm/秒
粒子径:約5~15μm(使用流体に依存)
対応薬液例:AZ-P4000シリーズ,SU8,KMPR,BCB,各種ポリマー
スパッタリング装置
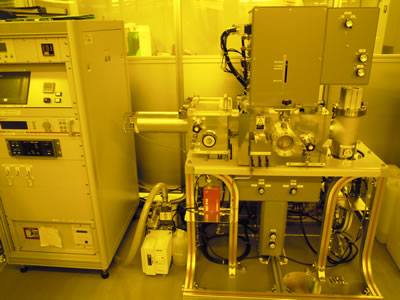
概要
本装置は,材料開発等の研究開発用途として要求される様々な機能に対して,幅広く対応できるスパッタリング装置です。ターゲットとしてはクロム,金,SiO2,プラチナ等に対応しており,同時に3つのターゲットを取り付け可能です。
仕様/性能
キヤノンアネルバ社製 E-200S
ターゲット:SiO2,Cr,Au,Pt
膜厚分布:Φ100 mm内±3%
基板ホルダー:Φ200 mm
基板加熱:Max 300℃(水冷付)
パリレンコーティング装置
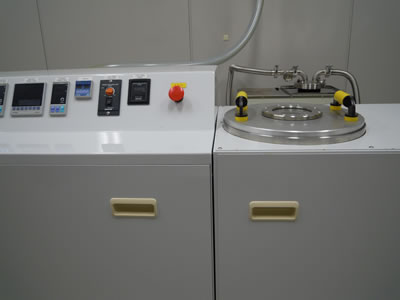
概要
本装置は,diXをCVDを用いてコンフォーマルにコーティングする装置です。装置は気化・分解炉,蒸着チャンバー,チラーユニット,真空ポンプの4つから構成されており,コーティングは減圧下で行われ,コーティング原料であるdiXを気化室にて気化します。分解炉で650~700℃の加熱によりdiXが熱分解されモノマーになり,モノマーが蒸着チャンバー内で被着体に接触すると,その界面でモノマーが重合し,高分子量ポリパラキシリレン膜が形成されます。
仕様/性能
KISCO社製 DACS-LAB
蒸着チャンバー寸法:ID300 × H350 mm
回転:0.5~10rpm
原子層堆積装置
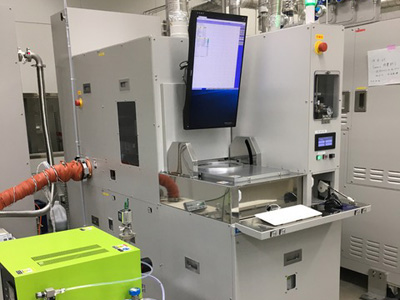
概要
反応室に有機金属原料と酸化剤を交互に供給し,表面反応のみを利用して成膜を行う装置です.Al2O3, SiO2, AlOxNy, SiOxNyの成膜が可能です.
仕様/性能
サムコ製 AD-100LE
基板サイズ:212 mmΦ
加熱温度:最大500℃
ガス導入系:有機金属系2系統,H2O,O2,N2
プラズマ誘起CVD装置
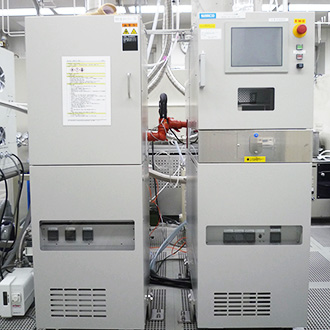
概要
本装置は,プラズマを用いて基板上にシリコン酸化膜を堆積する成膜装置です.TEOSを液体ソースとして用いてSiO2膜を堆積します.
仕様/性能
サムコ製 PD-220N
基板加熱:抵抗加熱式 (常用300℃)
適正ウェハ寸法:最大8インチ径
供給ガス:TEOS
