露光・描画装置
電子線露光装置
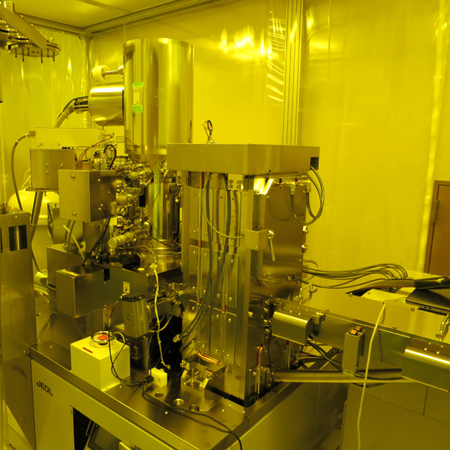
概要
本装置は,ナノメートルサイズのパターンを電子ビームで描画することができ,クラス1000のクリーンルームに設置されている.クリーンルーム内のスピナー,ベーク炉,ドラフトチャンバなどを合わせて利用することで,レジスト塗布,電子線描画,現像,RIEによる微細加工,イオン注入などのプロセスを行うことができる.
仕様/性能
日本電子製JBX6300FS
加速電圧:25 kV / 50 kV / 100 kV
電子銃エミッタ:ZrO/W (Schottky)
最小ビーム径:2 nm
ビーム電流値:100 pA - 2 nA
描画方式:ベクタースキャン
重ね合わせ精度:9 nm
最大試料サイズ:4 inchφ
レーザー描画装置

概要
フォトマスクの作製や直接描画を行うことができます.パターン寸法により0.6μmと1μmの描画ヘッドが選択できます.また,レーザーのフォーカスも光学かエアーが選べ,各種基板に対応可能です.
仕様/性能
Heidelberg Instruments社製 DWL66FS
描画方式:ラスタ・スキャン方式
レーザー源:ダイオードレーザー(405nm)
最小描画サイズ:0.6μm
描画スピード(1μmヘッド):10m㎡/min
最大描画サイズ:200mmX200mm
最小基板サイズ:15mmX15mm
コンバージョンソフト:DXF,CIF,GDSⅡ,Garberファイル
レーザ描画装置

概要
本装置は,直接描画アプリケーション,及びマスク作製用のパターンジェネレーターです。デザインされた描画パターンを,250,000dpiの解像度で描画できます。MEMS, BioMEMS, 集積光学,マイクロ流体光学などの,高精度・高解像度の微細構造を作製可能です。
仕様/性能
Heidelberg Instruments社製 µPG101-UV
対応基板:100 mm ×100 mm
加工精度:3 µm
最小アドレスグリッド:100 nm
アライメント用カメラシステム:有
対応データ:DXF,CIF,BMP
マスクレス露光装置

概要
本装置は,CADデータにした任意の形状をパターンニングすることのできる露光装置で,フォトマスクを使用せずに様々なパターンを作製することができます。描画用にDigital Micromirror Device(DMD)を用いることで,走査型露光装置にはない高い生産性を持ちます。
仕様/性能
ナノシステムソリューションズ製 DL-1000
最大露光面積:200 mm x 200 mm
最小画素:1 µm(高精細露光機能付)
つなぎ合わせ精度:0.1 µm
重ね合わせ精度:±1 µm
オートフォーカス機能有
露光プロセス(両面露光装置&スピンナー)
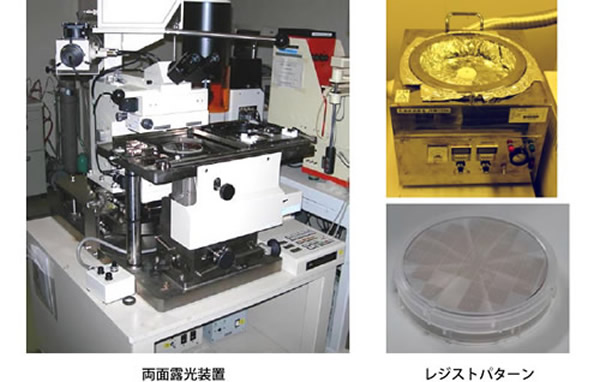
概要
基板の表裏にレジストパターンを形成できます.光学式位置合わせ方式を用いており,基板上に金属薄膜が形成されていてもパターニングが可能です.また,不定形基板に対しても対応可能になっております.MEMSデバイスに限らず,微細加工に幅広く活用できます.
仕様/性能
ユニオン光学社製 PEM800
マスクサイズ(最大):5インチ
ウエハサイズ:不定形~φ4インチ
露光装置:250W超高圧水銀灯
アライメント精度:5μm以下
露光方式:プロキシミティ,コンタクト両方式が可能
解像度:3μm L/S
フォトリソグラフィ装置
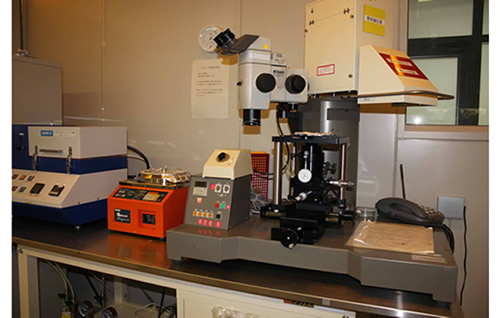
概要
3線(365,405,436nm)高圧水銀ランプのマスクアライナです.同軸照射照明付き実体顕微鏡が付いていますので,重ね合わせ露光が可能です.
仕様/性能
アライナ
共和理研社製 K310P100S
基板サイズ:最大2インチ
マスクホルダー:3インチ
最小パタンサイズ:2μm
スピナー
ミカサ MS-A100
マスクアライナ一
概要
本装置は,リソグラフィー技術を用いて,Siウェハ,ガラスウェハ及び小片基板に塗布したフォトレジストに対してサブミクロン域の微細パターンをサブミクロンレベルの高い重ね合わせ精度で加工する手動式紫外線露光装置です.紫外線の照射エリアは最大6インチ径あり,最小10mmから最大6インチウェハに対応しています.
仕様/性能
Suss Micro Tec AG社製 MA-6
対応基盤サイズ:10mm~最大6インチ径ウェハ(角基板の場合は最大4インチ角)
主波長:350~450nmブロードバンド露光(i線,g線,h線)
i線露光:365nm(フィルタ使用)
露光エリア:6インチ径
面内照度均一性:±2.5%以内(6インチ径面内)
裏面アライメント機能(CCD画像記憶方式)
マスクアライナ一
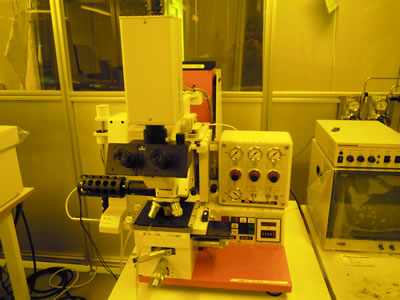
概要
本装置は,リソグラフィー技術を用いて,Siウェハ,ガラスウェハ及び小片基板に塗布したフォトレジストに対して微細パターンを高い重ね合わせ精度で加工する手動式紫外線露光装置です。紫外線の照射エリアは最大4インチ径あり,赤外線照明を用いた両面露光が可能です。
仕様/性能
Suss Micro Tec AG社製 MJB-3
最大ウェーハサイズ:3 inch(吸引モード),4 inch(ソフトコンタクト)
照射範囲:3×3 inch
対応基板厚さ:4.5 mm
両面露光:可能(赤外線照明)
マスクアライナ一
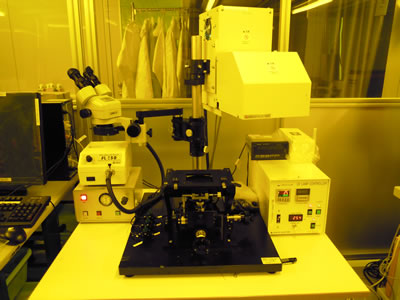
概要
本装置は,リソグラフィー技術を用いて,Siウェハ,ガラスウェハ及び小片基板に塗布したフォトレジストに対して微細パターンを高い重ね合わせ精度で加工する手動式紫外線露光装置です。紫外線の照射エリアは最大100mm□あり,片面露光が可能な装置です。
仕様/性能
ナノテック社製 LA410
適応マスク:最大 5 inch
適応資料:最大Φ4 inch
有効露光範囲:Φ80 mm以上
ナノインプリント装置
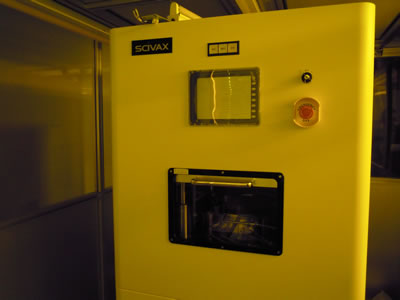
概要
本装置は、ナノメートルオーダの微細パターンを高い再現性で,小面積から大面積まで一括転写可能な装置です。熱式・UV式の量形式に対応しています。UV硬化樹脂,熱可塑性樹脂,熱硬化性樹脂等,幅広い材料に対応しています。
仕様/性能
SCIVAX社製 X-300 BVU-ND
形式:熱式,UV式
最大ワークサイズ:Φ150 mm
最大荷重:50 KN
最高仕様温度:250℃,650℃
UV機能:波長 365 nm/385 nm
有効照射面積:100 mm□
高精度電子線描画装置
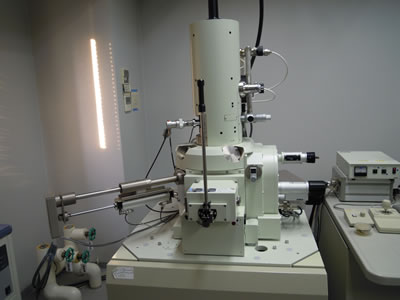
概要
本装置は,ナノメートルサイズのパターンを電子ビームで描画することが可能です。隣接するクリーンルームに設置しているスピンコータ,ほっとプレート,スパッタリング装置,などを合わせて利用することで,レジスト塗布,電子線描画,薄膜形成等多くのプロセスを実施できます。
仕様/性能
日本電子社製 SPG-724
描画方式:ラスタースキャン方式/ブロックスキャン方式
描画フィールド:50μm□/100μm□/200μm□/500μm□(ラスタースキャン)
2,500μm□ 1ブロック=2.5μm□ (ブロックスキャン)
スキャンスピード:0.5~10,000μsec/ピクセル(設定単位:0.1μsec/ピクセル)
※搭載SEM仕様
補償分解能:1.2 nm(30kV)
倍率:×10~×1,000,000
試料室:最大200 mm
マスクレス露光装置
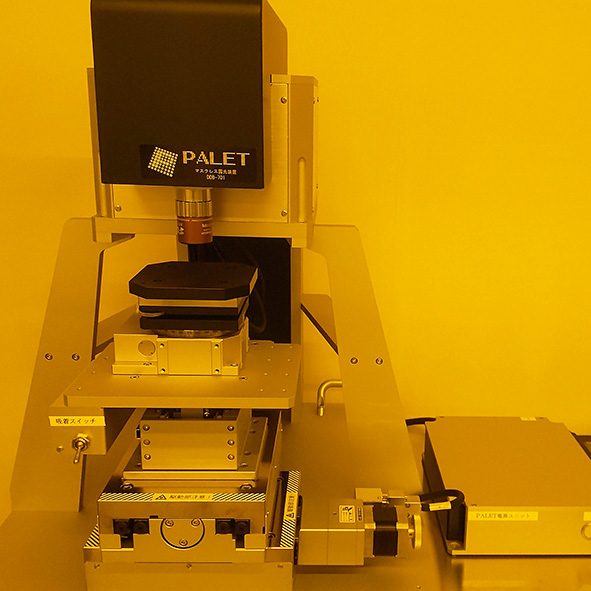
概要
本装置は,描画用にDigital Micromirror Device(DMD)を用いており,CADデータにした任意の形状をパターンニングすることのできる露光装置で,フォトマスクを使用せずに様々なパターンを作製することができます。本装置は,フォトリソグラフィに不慣れな人でも露光作業に迷わず,直感的に操作することができます。
仕様/性能
ネオアーク社製 PALET DDB-701-DL4
露光領域:100 mm x 100 mm
最大ワークサイズ:Φ150mm x 10 mmt
光源:365 nm LED
最小画素:3 µm(対物レンズx10),15 µm(対物レンズx2)
電子線描画用データ処理ソフトウェア

概要
本ソフトウェアは,電子線露光における近接効果を補正し,目的のパターンを得るために最適な露光データを生成します.また,グレースケール露光にも対応し,3次元構造のレジスト露光データを生成します.
仕様/性能
GenISys社製 BEAMER
レイアウトエディタ
パターンデータ変換
近接効果補正(PEC)
グレースケール露光補正
